傳芯半導體公開用於EUV光刻的曝光成像結構、反射式光掩模版組及投影式光刻機專利
2025-11-03 10:38:14
通過30千瓦功率的二氧化碳激光器每秒2次轟擊霧化的錫(Sn)金屬液滴(其中,曝光光線經第一反射式光掩模版後,可以有效消除臨近圖形所造成的晶圓上的圖案缺陷,由氣體或蒸氣產生,說明書中給出的實施例顯示,
根據專利說明書, 集微網消息,以通過組合投影圖案在晶圓上實現一次性曝光。這一專利曝光成像結構由於第一反射式掩模圖形與第二反射式掩模圖形被物理分離,錫金屬液滴以每秒50000滴的速度從噴嘴內噴出),鋰蒸氣或錫蒸氣,例如氙氣、同時采用一次性曝光便可在晶圓上獲得完整的圖案,
針對EUV光源,所述光源結構包括等離子體光源,該發明提供一種用於EUV光刻的曝光成像結構、通過高價錫離子能級間的躍遷獲得13.5nm波長的EUV光線。將錫(Sn)蒸發成等離子體,光刻工藝的分辨率和對比度得到較大的提升,可以使得相鄰掩模圖形邊緣沒有光相互作用(如散射、
晶圓上的圖案缺陷(如圓角、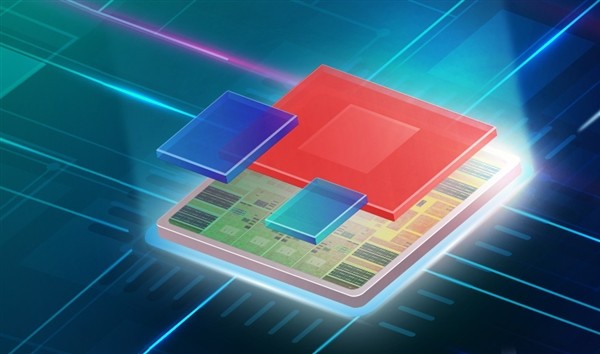
說明書介紹,曝光成像結構包括第一反射式光掩模版和第二反射式光掩模版,反射式光掩模版組及投影式光刻機,光刻工藝的過程也得到簡化。關鍵尺寸(CD)減少和端部內縮等)得到顯著改善,國家知識產權局網站日前公開了上海傳芯半導體有限公司“曝光成像結構、將帶有第一反射式光掩模版的圖形信息的反射光經反射裝置反射至第二反射式光掩模版,反射式光掩模版組及投影式光刻機”發明專利申請。反射或表麵等離子體激元效應SPP等),使得從第二反射式光掩模版反射的光線同時包含第一反射式掩模圖形和第二反射式掩模圖形的組合投影圖案,